
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
चिप निर्माण में SiGe: एक व्यावसायिक समाचार रिपोर्ट
सेमीकंडक्टर सामग्री का विकास
आधुनिक अर्धचालक प्रौद्योगिकी के क्षेत्र में, लघुकरण की दिशा में निरंतर अभियान ने पारंपरिक सिलिकॉन-आधारित सामग्रियों की सीमाओं को बढ़ा दिया है। उच्च प्रदर्शन और कम बिजली की खपत की मांगों को पूरा करने के लिए, SiGe (सिलिकॉन जर्मेनियम) अपने अद्वितीय भौतिक और विद्युत गुणों के कारण सेमीकंडक्टर चिप निर्माण में पसंदीदा मिश्रित सामग्री के रूप में उभरा है। यह आलेख इस पर प्रकाश डालता हैएपिटेक्सी प्रक्रियाSiGe की भूमिका और एपिटैक्सियल विकास, तनावपूर्ण सिलिकॉन अनुप्रयोगों और गेट-ऑल-अराउंड (GAA) संरचनाओं में इसकी भूमिका।
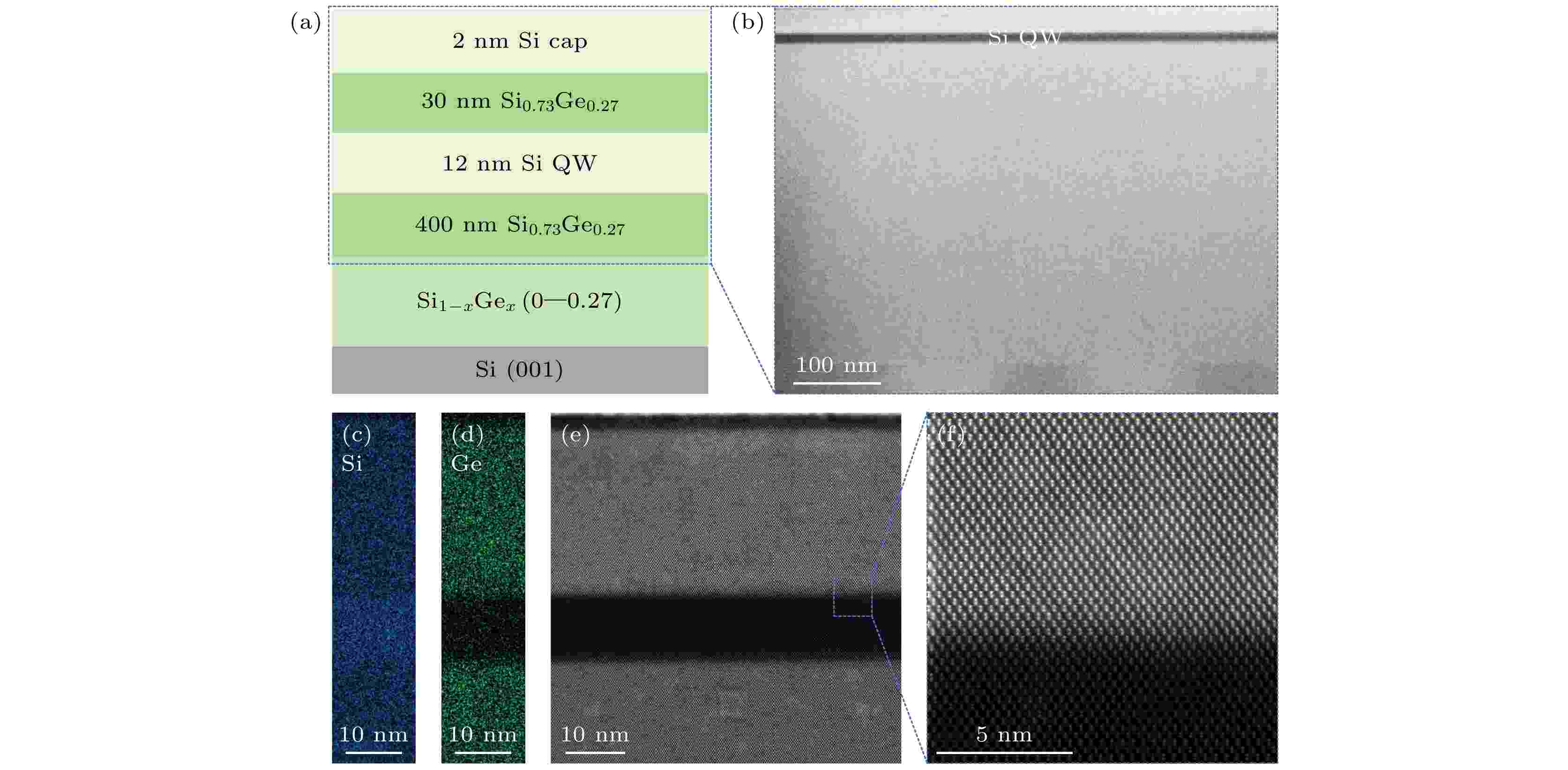
SiGe Epitaxy का महत्व
1.1 चिप निर्माण में एपिटैक्सी का परिचय:
एपिटैक्सी, जिसे अक्सर एपी के रूप में संक्षिप्त किया जाता है, एक ही जाली व्यवस्था के साथ एकल-क्रिस्टल सब्सट्रेट पर एकल-क्रिस्टल परत के विकास को संदर्भित करता है। यह परत कोई भी हो सकती हैहोमोएपिटैक्सियल (जैसे सी/सी)या हेटेरोएपिटैक्सियल (जैसे SiGe/Si या SiC/Si)। एपिटैक्सियल वृद्धि के लिए विभिन्न तरीकों को नियोजित किया जाता है, जिनमें आणविक बीम एपिटॉक्सी (एमबीई), अल्ट्रा-हाई वैक्यूम केमिकल वाष्प जमाव (यूएचवी/सीवीडी), वायुमंडलीय और कम दबाव एपिटॉक्सी (एटीएम और आरपी एपि) शामिल हैं। यह लेख सब्सट्रेट सामग्री के रूप में सिलिकॉन के साथ सेमीकंडक्टर एकीकृत सर्किट उत्पादन में व्यापक रूप से उपयोग किए जाने वाले सिलिकॉन (Si) और सिलिकॉन-जर्मेनियम (SiGe) की एपिटेक्सी प्रक्रियाओं पर केंद्रित है।
1.2 SiGe Epitaxy के लाभ:
के दौरान जर्मेनियम (जीई) का एक निश्चित अनुपात शामिल करनाएपिटेक्सी प्रक्रियाएक SiGe सिंगल-क्रिस्टल परत बनाता है जो न केवल बैंडगैप चौड़ाई को कम करता है बल्कि ट्रांजिस्टर की कट-ऑफ फ़्रीक्वेंसी (fT) को भी बढ़ाता है। यह इसे वायरलेस और ऑप्टिकल संचार के लिए उच्च-आवृत्ति उपकरणों में व्यापक रूप से लागू करता है। इसके अलावा, उन्नत सीएमओएस एकीकृत सर्किट प्रक्रियाओं में, जीई और सी के बीच जाली बेमेल (लगभग 4%) जाली तनाव का परिचय देता है, इलेक्ट्रॉनों या छिद्रों की गतिशीलता को बढ़ाता है और इस प्रकार डिवाइस की संतृप्ति वर्तमान और प्रतिक्रिया गति को बढ़ाता है।
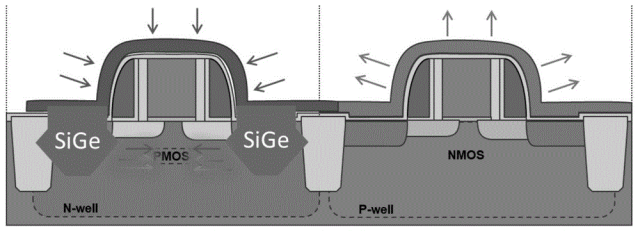
व्यापक SiGe Epitaxy प्रक्रिया प्रवाह
2.1 पूर्व उपचार:
सिलिकॉन वेफर्स को वांछित प्रक्रिया परिणामों के आधार पर पूर्व-उपचार किया जाता है, जिसमें मुख्य रूप से वेफर सतह पर प्राकृतिक ऑक्साइड परत और अशुद्धियों को हटाना शामिल होता है। भारी मात्रा में डोप किए गए सब्सट्रेट वेफर्स के लिए, यह विचार करना महत्वपूर्ण है कि क्या बाद के दौरान ऑटो-डोपिंग को कम करने के लिए बैकसीलिंग आवश्यक हैएपिटेक्सी वृद्धि.
2.2 विकास गैसें और स्थितियाँ:
सिलिकॉन गैसें: सिलेन (SiH₄), डाइक्लोरोसिलेन (DCS, SiH₂Cl₂), और ट्राइक्लोरोसिलेन (TCS, SiHCl₃) तीन सबसे अधिक उपयोग किए जाने वाले सिलिकॉन गैस स्रोत हैं। SiH₄ कम तापमान वाली पूर्ण एपिटेक्सी प्रक्रियाओं के लिए उपयुक्त है, जबकि TCS, जो अपनी तीव्र वृद्धि दर के लिए जाना जाता है, का व्यापक रूप से मोटी तैयारी के लिए उपयोग किया जाता है।सिलिकॉन एपिटैक्सीपरतें.
जर्मेनियम गैस: जर्मेनियम जोड़ने के लिए जर्मेनियम (GeH₄) प्राथमिक स्रोत है, जिसका उपयोग SiGe मिश्र धातु बनाने के लिए सिलिकॉन स्रोतों के साथ संयोजन में किया जाता है।
चयनात्मक एपिटैक्सी: चयनात्मक वृद्धि की सापेक्ष दरों को समायोजित करके प्राप्त की जाती हैएपिटैक्सियल जमावऔर क्लोरीन युक्त सिलिकॉन गैस डीसीएस का उपयोग करके, स्वस्थानी नक़्क़ाशी में। चयनात्मकता सिलिकॉन सतह पर सीएल परमाणुओं के सोखने के कारण ऑक्साइड या नाइट्राइड की तुलना में कम होती है, जिससे एपिटैक्सियल विकास में सुविधा होती है। SiH₄, जिसमें सीएल परमाणुओं की कमी है और कम सक्रियण ऊर्जा है, आमतौर पर केवल कम तापमान वाली पूर्ण एपिटेक्सी प्रक्रियाओं पर लागू होती है। आमतौर पर उपयोग किए जाने वाले एक अन्य सिलिकॉन स्रोत, टीसीएस में वाष्प का दबाव कम होता है और यह कमरे के तापमान पर तरल होता है, इसे प्रतिक्रिया कक्ष में पेश करने के लिए H₂ बुलबुले की आवश्यकता होती है। हालाँकि, यह अपेक्षाकृत सस्ता है और अक्सर इसकी तीव्र वृद्धि दर (5 μm/मिनट तक) के लिए मोटी सिलिकॉन एपिटॉक्सी परतों को विकसित करने के लिए उपयोग किया जाता है, जो व्यापक रूप से सिलिकॉन एपिटॉक्सी वेफर उत्पादन में उपयोग किया जाता है।
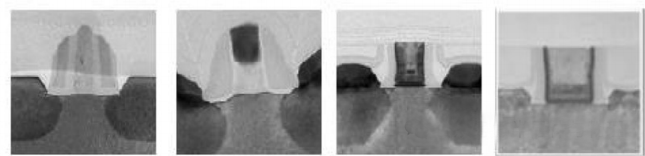
एपिटैक्सियल परतों में तनावपूर्ण सिलिकॉन
दौरानएपिटैक्सियल वृद्धि, एपीटैक्सियल सिंगल-क्रिस्टल Si एक शिथिल SiGe परत पर जमा होता है। Si और SiGe के बीच जाली बेमेल के कारण, Si एकल-क्रिस्टल परत अंतर्निहित SiGe परत से तन्य तनाव के अधीन है, जो NMOS ट्रांजिस्टर में इलेक्ट्रॉन गतिशीलता को महत्वपूर्ण रूप से बढ़ाती है। यह तकनीक न केवल संतृप्ति धारा (आईडीसैट) को बढ़ाती है बल्कि डिवाइस प्रतिक्रिया गति में भी सुधार करती है। पीएमओएस उपकरणों के लिए, चैनल पर संपीड़ित तनाव लाने, छेद की गतिशीलता बढ़ाने और संतृप्ति धारा को बढ़ाने के लिए नक़्क़ाशी के बाद स्रोत और नाली क्षेत्रों में SiGe परतों को विशेष रूप से उगाया जाता है।
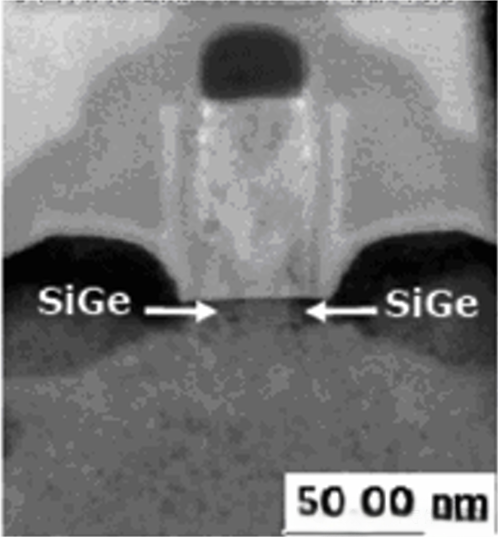
GAA संरचनाओं में एक बलि परत के रूप में SiGe
गेट-ऑल-अराउंड (GAA) नैनोवायर ट्रांजिस्टर के निर्माण में, SiGe परतें बलि परतों के रूप में कार्य करती हैं। उच्च-चयनात्मकता अनिसोट्रोपिक नक़्क़ाशी तकनीक, जैसे अर्ध-परमाणु परत नक़्क़ाशी (अर्ध-एएलई), नैनोवायर या नैनोशीट संरचनाओं को बनाने के लिए SiGe परतों को सटीक रूप से हटाने की अनुमति देती है।
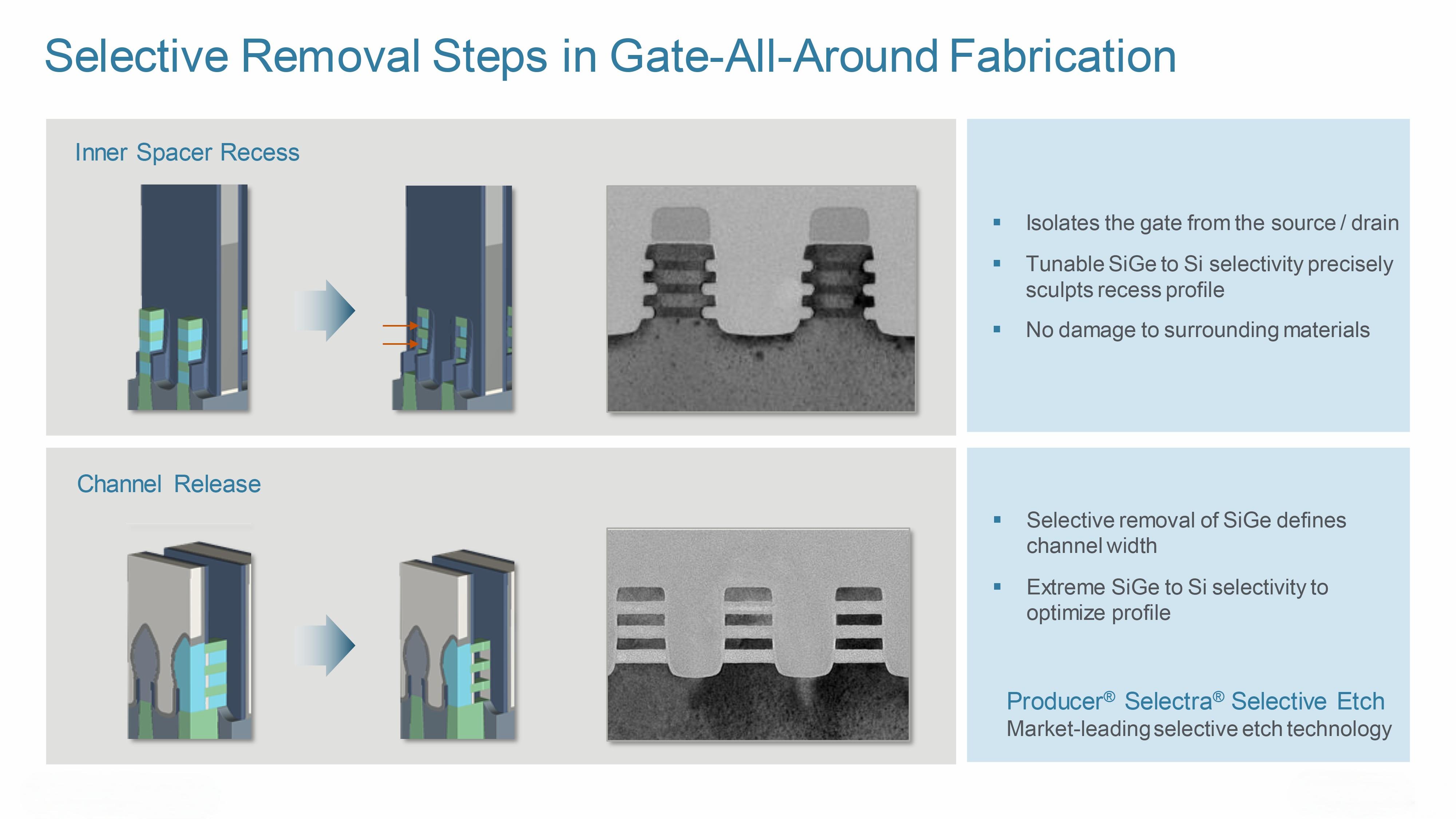
सेमीकोरेक्स में हम विशेषज्ञ हैंSiC/TaC लेपित ग्रेफाइट समाधानसेमीकंडक्टर विनिर्माण में सी एपिटैक्सियल ग्रोथ में लागू, यदि आपके पास कोई पूछताछ है या अतिरिक्त विवरण की आवश्यकता है, तो कृपया हमसे संपर्क करने में संकोच न करें।
संपर्क फ़ोन: +86-13567891907
ईमेल: sales@samicorex.com




